【背景】
三次元集積回路の微細化の要求に対応すべく、直径11μmの微細TSVの制作に取り組んだ
微細化する際に必要となったプロセス改善技術について紹介する
【設計・構造】
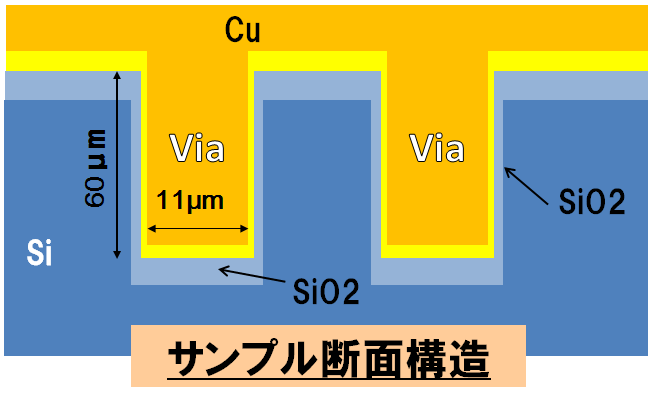
- プロセスフロー
- ・フォトリソ(TSV)
・Siエッチング(TSV)
・レジスト除去
・絶縁膜形成
・シードスパッタ(Ti/Cu)
・Cuフィリングめっき
| プロセス | ・Siエッチング(TSV) |
|---|---|
| 目標 | ・垂直にストレートな形状 |
| 改善方法 | ・穴底保護膜除去の最適化 ・Top開口を大きくする |
【プロセスポイント】
■Siエッチング
(Boschプロセス)
右図の繰り返しによる
高速エッチング
- プロセスポイント
■エッチング形状改善①
φ50μmTSVで最適化されたレシピを
φ11μmTSVに適応すると
穴底が細くなる × 穴底が荒れる ×
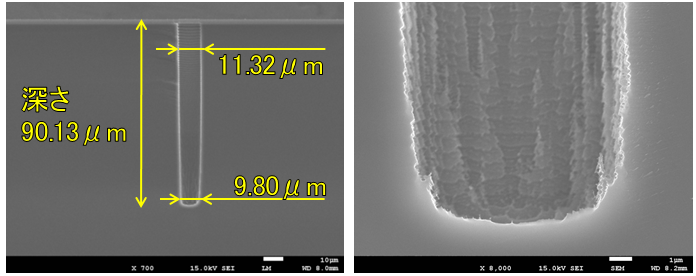
■エッチング形状改善②
TSV内壁の絶縁膜にCVDを適用すると…
トップが狭まりスパッタが入りにくくなる ×
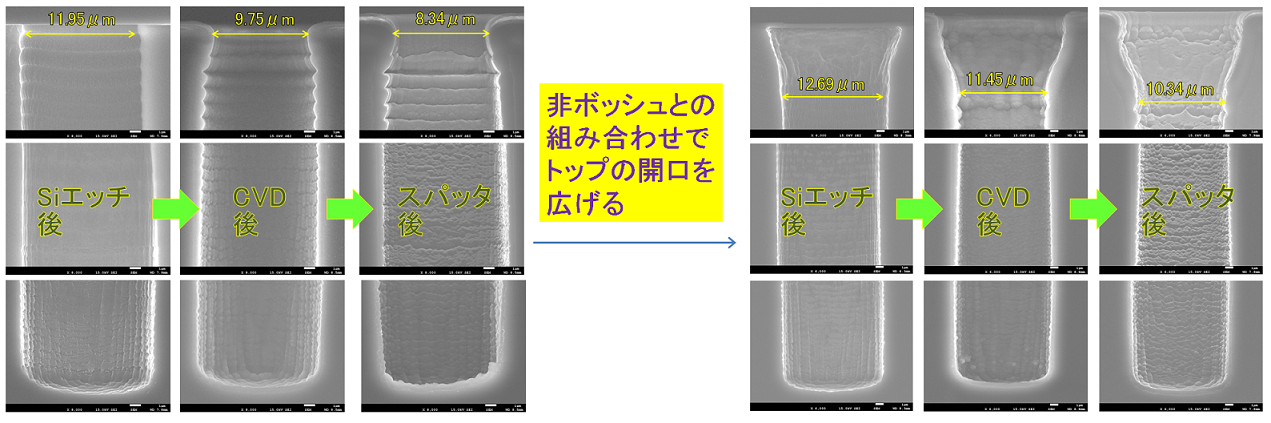
【製造フロー】
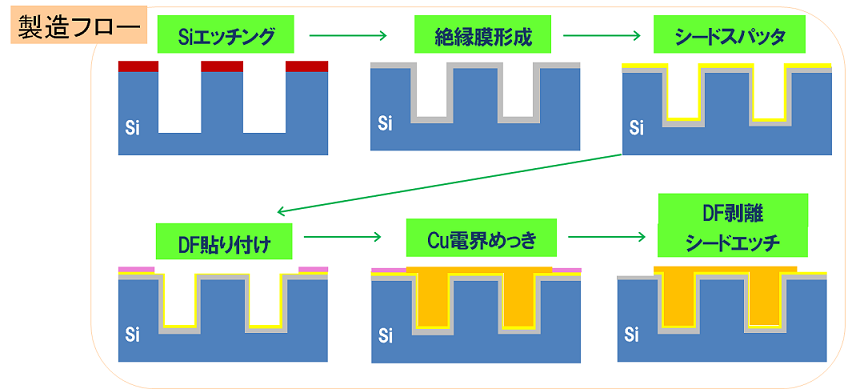
【I-V測定方法】
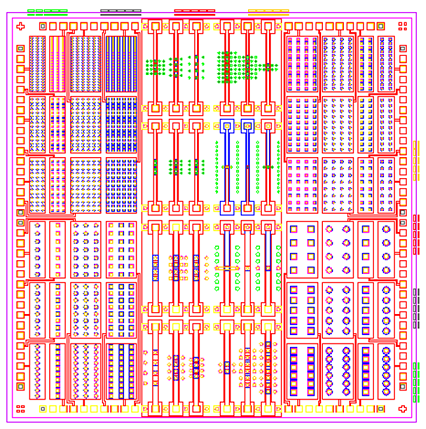
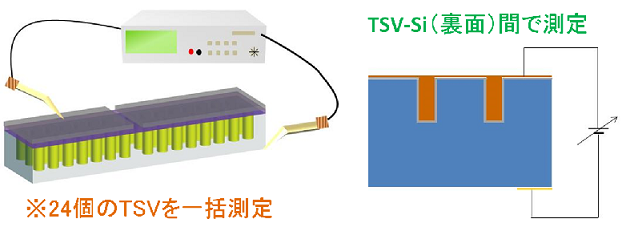
【TSVのI-V特性評価】
直径50μm(深さ100μm)のTSVと同等レベルの絶縁性を示し、膜厚の影響も少ない